AR-P-6200 (CSAR62)
Tone | Positive | ||||||||||||||
Reference | All resist: https://www.allresist.com/portfolio-item/e-beam-resist-ar-p-6200-series-csar-62/ | ||||||||||||||
Spin coat |
| ||||||||||||||
Prebake | 150°C, 3 minutes on hotplate or 30 min on plate in oven | ||||||||||||||
Exposure | Clearance dose 180µC/cm² | ||||||||||||||
Development | X AR 6000-54/6 or pentylacetate for 60s | ||||||||||||||
Rinse | MIBK:IPA=1:1 for 60s, followed by IPA for 60s | ||||||||||||||
| or | |||||||||||||||
| o-xylene 5s, followed by IPA for 60s (this option reduces the amount of residues) |
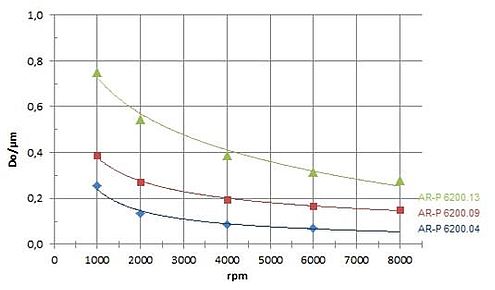
In the table below you can find the etchrates for different plasmas:
| Etchrate gas 1 [nm/min] | Etchrate gas 2 [nm/min] | Etchrate gas 3 [nm/min] | Etchrate gas 4 [nm/min] |
CSAR62 | 66 | 93 | 29 | 54 |
PMMA | 104 | 133 | 44 | 71 |
ZEP 520A | 64 | 86 | 27.5 | 48 |
Gas 1: etcher F2, 20sccm O2, 40W, lowest pressure, bias -541V à -648V
Gas 2: etcher F2, 12.5sccm SF6, 10sccm He, 2.5sccm O2, 10µbar, 40W, bias -210V
Gas 3: etcher F1, 50sccm CHF3, 2.5sscm O2, 8.6µbar, 50W, bias -442V
Gas 4: etcher F1, 50sccm CHF3, 2.5sccm O2, 50µbar, 100W, bias -613V